
G2C+聯盟今年在國際半導體展(2025 SEMICON Taiwan),再次展現驚人氣勢,聯盟展位在N076221,由21個攤位、上下兩樓層設計打造。展位內兩張CoWoS、PLP製程FLOW charts格外吸睛,標示出聯盟三雄: 志聖(2467)、均豪(5443)、均華(6640)在供應鏈的重要地位。其中,東捷科技合展,G2C+聯盟新成員樂林科技首度亮相。
強大整合平台 創下同業合作典範
國內半導體設備廠在後段製程與先進封裝擠進一階供應商,G2C+聯盟占有重要位置,創下同業合作典範;志聖、均豪與均華分別專注ERP導向設備、3D量測、研磨與拋光技術以及自動分類設備,打造強大整合平台,協助客戶加速導入製程,互為信賴夥伴。
半導體技術日新月異,製程上千道,CPO光通路、晶背供電等新技術與時俱進。許多主流技術都有大廠在背後撐腰,台積電、美光、日月光、矽品、欣興等業界領頭羊最常被點名,TGV、PLP由於技術瓶頸,市場應用仍在醞釀,但未來仍具潛力。迄今,聯盟合計已投入研發人力超過560人,換算產業資歷遠超過100年,且仍積極投入中。
志聖熱技術功力一甲子 再攀新高
志聖成立至今,正式邁入60年,擁有一甲子熱技術功力,其壓、貼、撕、烤與Plasma技術廣泛應用,從傳產到科技業全面覆蓋。尤其擅長的客製化加熱烘烤設備為今年展出亮點;先進封裝製程內站穩供應鏈的Bonder、撕膜/壓膜設備等也受到關注。

在Foundry 2.0趨勢下,以台積電為首的各大廠紛紛啟動向下整合測試與封裝流程,志聖在晶圓製造、SoIC、HBM與IC載板等領域,密切跟進客戶製程需求,同時導入除泡與玻璃基板技術,並拓展至OSAT與終端測試應用市場,強化工程研發能力,掌握3DIC、先進封裝與AI應用的成長契機。
其中,壓力烤箱熱度居高不退,志聖10幾年就投入開發,可惜投入時間比市場的需求早,直至4年前客戶需求明朗,市占逐步攀升,也受邀參與新製程研發,顯見受倚重的程度。志聖持續提升公司治理透明度,2026年以躋身公司治理評鑑前5%行列為目標,實現對永續與責任治理的承諾,並投入ISO 14067碳盤查認證,配合客戶中長期的淨零排放目標。
均豪擅檢量磨拋 通吃光電半導體
均豪成立47年,聚焦「檢、量、磨、拋」四大核心技術,在半導體業發揮最大價值,可對接FOPLP與TGV製程,其中又以晶圓再生的拋光與檢查為重點業務。
均豪開發的高精度CMP拋光,符合客戶要求;檢查方面以自動光學檢測(AOI)為技術主軸,不管穿透與非穿透都能檢查,用於高階先進封裝製程的玻璃載體(Carrier),也針對非玻璃材質的特殊材料檢查與客戶展開研發,近期已進入客戶端產線進行驗證。
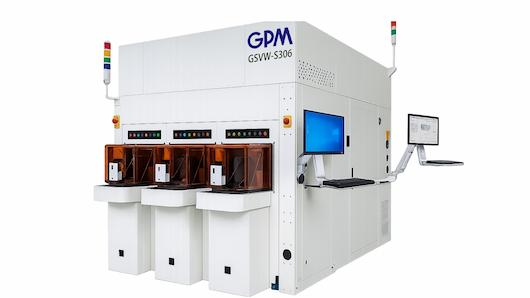
每片正式投片的晶圓必須搭配再生晶圓才能完整產出,隨著晶圓大廠提升資本支出與擴產需求,再生晶圓的商機無限;國內各再生晶圓廠近期宣布提升產能積極擴產,均豪為再生晶圓大廠策略夥伴,合作更密切。
均華CoWoS製程設備 獨領風騷
均華於2010年成立,至今15年。以P&P技術開發各種應用機台,鑽研Fanout扇形封裝、SiP系統級先進封裝及多工異質整合,在CoWoS製程搶下灘頭堡,獨領市場風騷。其中,6面檢查設備市場吸睛市占高;Die Bonder也是主力。
在精密取放挑揀、黏晶技術與雷射應用方面,晶片挑揀機用於先進封裝製程,高精度黏晶機可以無人化控制,高速切單機(JIG SAW)已通過重要客戶認證,賣進晶圓與封測一線大廠。

從單機到整線,均華展現技術全面掌握度與整合能力,先進封裝營收比重超過70%。當部份同業受挫於單機無法突破時,均華已接獲美系國際晶片大廠專線開發委託,去年並獲頒台積電最佳供應商獎。
前景持續看好 集體行動共創致遠
G2C+聯盟在半導體與先進封裝提供一站式服務,三家公司前景持續看好。觀察各家營收,均華以半導體為其主營收;均豪半導體營收比例超過5成,並持穩步提升中,今年6月獲櫃買中心肯定,調整產業類別改掛半導體類股,展現升級轉型有成;志聖的產品最多元,應用面也最廣,其中,半導體營收比重也逐年提升。
G2C+聯盟2020年成立至今5周年,當初以合力共創、同行致遠的精神,凝聚志聖、均豪、均華及夥伴公司向心,不僅合作研發共享資源,透過交叉持股,更成為緊密的策略合作夥伴;隨著大客戶海外布局,目前,G2C+正認真思考配合客戶投資美國,10月將在志聖主導下實地考察。一旦投資,三家將再次集體行動,共創致遠。













